sic深加工
2021-10-28T03:10:49+00:00

碳化硅晶圆制造难在哪?做出200mm的凤毛麟角电子工程专辑
2021年8月3日 SiC器件成本高的一大原因就是SiC衬底制造困难。数据显示,衬底成本大约占晶片加工总成本的50%,外延片占25%,器件晶圆制造环节20%,封装测试环节5% 2022年1月21日 01 碳化硅晶片生产工艺流程 碳化硅晶片生产流程 碳化硅晶片以高纯硅粉和高纯碳粉作为原材料,采用物理气相传输法(PVT)生长碳化硅单晶,再在衬底上使用 碳化硅晶片加工过程及难点 知乎2023年4月28日 碳化硅衬底的加工主要分为以下几个工序,切割,粗磨,精磨,粗抛,精抛(CMP)。1切割 切割是将SiC晶棒沿着一定的方向切割成晶体薄片的过程。将SiC晶棒 详解碳化硅晶片的磨抛工艺方案 知乎

一文了解碳化硅(SiC)器件制造工艺 ROHM技术社
2022年12月1日 为了确保SiC器件的优质应用,本文将详细介绍SiC器件制造中的离子注入工艺和激活退火工艺。 离子注入是一种向半导体材料内部加入特定数量和种类的杂质,以改变其电学性能的方法,可以精确控制杂 2022年4月27日 近期,科研人员通过优化生长工艺,进一步解决了多型相变问题,持续改善晶体结晶质量,成功生长出单一4H晶型的8英寸SiC晶体,晶坯厚度接近196 mm,加工 8英寸碳化硅单晶研究获进展中国科学院2023年5月4日 碳化硅,是一种无机物,化学式为SiC,是用 石英砂 、石油焦(或煤焦)、木屑(生产绿色碳化硅时需要加食盐)等原料通过 电阻炉 高温冶炼而成。 碳化硅在大自然也存在罕见的矿物, 莫桑石 。 在C、N 碳化硅百度百科

上海微系统所发表关于碳化硅单晶薄膜制备技术及集成光子
2022年8月8日 SiC 材料是极具魅力的半导体光学平台,集多种优异特性于一身,继承了硅的优异性能,兼具与金刚石比拟的特性,结合目前在 SiC 非线性光学及 SiC 片上量子光学 2022年10月3日 我们利用 7 µm 深的沟槽,并且在其侧壁上注入 p,提出了一种 1700V SiC 超结器件[1]。 ROHM 器件不是超结器件,它们的 p 型沟槽只是我们提出的那些器件的一小部分,但我们怀疑超结原理在源极沟槽 碳化硅(SiC)纵览—第 4 期:罗姆第四代 SiC 2020年12月20日 SiC基芯片背面通孔刻蚀工艺研究 摘要:通过对感应耦合等离子体 (ICP)设备装片夹具进行改进,提高了背氦的导热效率,减小了下电极基底与晶圆表面之间的温度差,提高了冷却效果。 对装片夹具改进前后进行了对比实验,并分析了射频功率、ICP功率、 SiC基芯片背面通孔刻蚀工艺研究 知乎

黑碳化硅百度百科
2021年1月31日 ①黑碳化硅含SiC约985%,其韧性高于绿碳化硅,大多用于加工抗张强度低的材料,如玻璃、陶瓷、石材、耐火材料、铸铁和有色金属等。 ②绿碳化硅含SiC99%以上,自锐性好,大多用于加工硬质合金 2022年1月21日 碳化硅衬底加工难点 四、切割磨损高,由于碳化硅的硬度极大,在对其进行切割时加工难度较高且磨损多。 昂贵的时间成本和复杂的加工工艺使得碳化硅衬底的成本较高,限制了碳化硅的应用放量。 此外,晶片尺寸越大,对应晶体的生长与加工技术难度越 碳化硅晶片加工过程及难点 知乎2023年4月6日 以下是SiC MOSFET Rdson设计的一些关键考虑因素: 1 通道宽度和掺杂:SiC MOSFET的通道宽度和掺杂浓度会影响Rdson和电流密度。 较宽和重掺的通道可以降低Rdson并提高电流承载能力。 2 栅极氧化层厚度:栅极氧化层的厚度影响栅极电容,进而影响开关速度和Rdson 揭秘碳化硅芯片的设计和制造 知乎
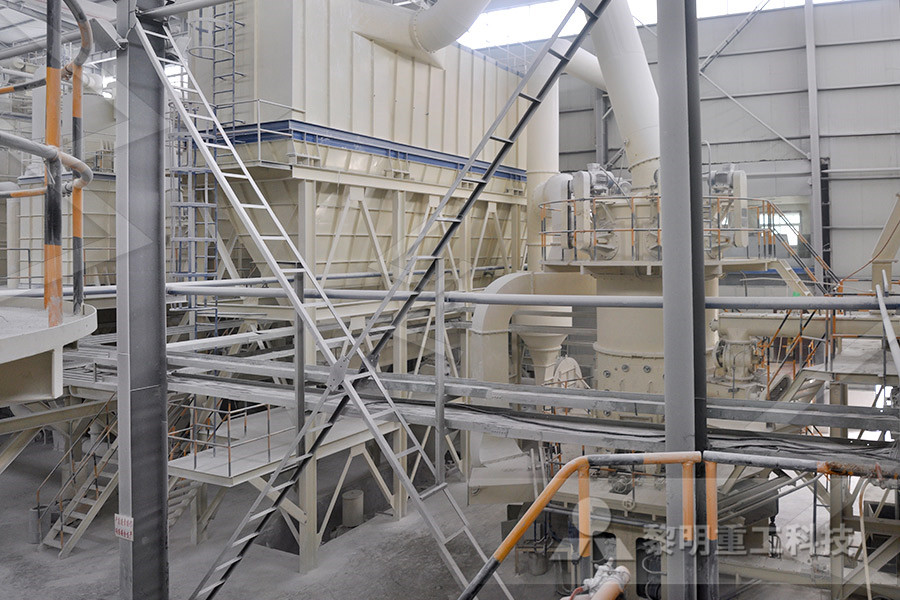
碳化硅(SiC)MOSFET性能的优势与技术的难点 知乎
2020年1月15日 另外,SiC MOSFET能够在IGBT不能工作的高频条件下驱动,从而也可以实现被动器件的小型化。 与600V~1200V的Si MOSFET相比,SiC MOSFET的优势在于芯片面积小(可以实现小型封装),而且体二极管的恢复损耗非常小。 2 SiC Mosfet的导通电阻 SiC 的绝缘击穿场强是Si 的10倍 2021年5月24日 SIC外延漫谈 目前所有的碳化硅器件基本上都是在外延上实现的,外延环节是产业链的中间环节,首先,器件的设计对外延的质量性能要求高影响非常大,同时外延的质量也受到晶体和衬底加工的影响,所以SIC外延环节对产业链的整体发展起到非常关键的作用 SIC外延漫谈 知乎2021年8月3日 做出200mm的凤毛麟角 同时期的硅晶圆已经由200mm(8英寸)向300mm(12英寸)进发,但碳化硅晶圆的主流尺寸一直是150mm(6英寸),每片晶圆能制造的芯片数量不大,远不能满足下游需求。 真的这么难吗? 包括SiC在内的第三代半导体产业链包括包括衬底→外延→ 碳化硅晶圆制造难在哪?做出200mm的凤毛麟角电子工程专辑

碳化硅单晶衬底切、磨、抛材料整体解决方案发展加工的表面
2022年10月28日 SiC单晶衬底加工过程包括单晶多线切割、研磨、抛光、清洗最终得到满足外延生长的衬底片。 SiC是世界上硬度排名第三的物质,不仅具有高硬度的特点,高脆性、低断裂韧性也使得其磨削加工过程中易引起材料的脆性断裂从而在材料表面留下表面破碎 2023年4月28日 碳化硅衬底的加工主要分为以下几个工序,切割,粗磨,精磨,粗抛,精抛(CMP)。1切割 切割是将SiC晶棒沿着一定的方向切割成晶体薄片的过程。将SiC晶棒切成翘曲度小,厚度均匀的晶片,目前常规的切割方式是多线砂浆切割 2研磨详解碳化硅晶片的磨抛工艺方案 知乎2020年3月6日 摘要: 采用搅拌摩擦加工(FSP)技术对SiC颗粒增强2A14铝合金(SiC P /2A14)复合材料进行处理,通过金相表征、电子背散射衍射(EBSD)、SEM、硬度测试及力学拉伸实验等分析了多道次搅拌摩擦加工 多道次搅拌摩擦加工对SiC P /2A14铝合金复合材料显

SiC行业深度报告:SiC全产业链拆解,新能源行业下一
2022年10月29日 SiC行业深度报告:SiC全产业链拆解,新能源行业下一代浪潮之基(上) 1 SiC 性能优异,材料升级势在必行 SiC 是第三代宽禁带半导体材料,在禁带宽度、击穿场强、电子饱和漂移速度等 物理特性上 2022年10月21日 SiC增强体颗粒比常用的刀具(如高速钢刀具和硬质合金刀具)的硬度高得多,在机械加工的过程 中会引起剧烈的刀具磨损。 PCD金刚石刀具虽然比增强体颗粒的硬度高 ,但硬度值相差不大 ,在切削加工高体分(SiC颗粒含量在 60% ~70%)的颗粒增强AISiC复合材料时仍然会快速磨损 ,且PCD金刚石刀具成本更 铝基碳化硅加工难度大的原因是什么? 知乎2021年6月8日 碳化硅(SiC)材料是功率半导体行业主要进步发展方向,用于制作功率器件,可显着提高电能利用率。可预见的未来内,新能源汽车是碳化硅功率器件的主要应用场景。 特斯拉 作为技术先驱,已率先在Model 3中集成全碳化硅模块,其他一线车企亦皆计划扩大碳 第三代半导体材料之碳化硅(SiC) 碳化硅(SiC)材料是功率

什么是碳化硅(SiC)陶瓷?用途及其制作方法? 知乎
2023年9月12日 碳化硅是如何制造的? 最简单的碳化硅制造方法包括在高达 2500 摄氏度的高温下熔化硅砂和碳(例如煤)。 颜色更深、更常见的碳化硅通常含有铁和碳杂质,但纯 SiC 晶体是无色的,是碳化硅在 2700 摄氏度升华时形成的。 加热后,这些晶体会在较低温 2023年5月4日 碳化硅,是一种无机物,化学式为SiC,是用石英砂、石油焦(或煤焦)、木屑(生产绿色碳化硅时需要加食盐)等原料通过电阻炉高温冶炼而成。碳化硅在大自然也存在罕见的矿物,莫桑石。在C、N、B等非氧化物高技术耐火原料中,碳化硅为应用最广泛、最经济的一种,可以称为金钢砂或耐火砂。碳化硅百度百科2020年12月23日 因此,深入研究SiC磨削机理与亚表面损伤对于提高SiC磨削加工 效率和表面质量具有重要意义。1、硬脆材料的研磨机理 对硬脆材料进行研磨,磨料对其具有滚轧作用或微切削作用。磨粒作用于有凹凸和裂纹的表面上时,随着研磨加工的进行,在 第三代半导体材料之碳化硅(SiC) 百家号

新型铝基碳化硅材料(AISIC)制备方法及SICP新型材料应用
2022年1月19日 SiC增强铝基复合材料,由于具有热膨胀系数小、密度低及导热性能好等优点,适合于制造电子器材的衬装材料及散热片等电子器件。SiC颗粒增强铝基复合材料的热膨胀系数完全可以与电子器件材料的热膨胀相匹配,而且导电、导热性能也非常好。2022年5月18日 功率SiC供应链中的主要中国专利申请人 整个价值链上的创新,及时应对新兴功率SiC市场的捷径 尽管许多厂商都在积极构建垂直整合的供应链,以确保其SiC业务的长期安全,但很少有厂商能够开发出覆盖整个SiC价值链的强大专利组合,日本的丰田和电装除 功率碳化硅(SiC)专利全景分析2022版 知乎2023年8月19日 为什么碳化硅SiC要先制作衬底,再在衬底上外延SiC 制成外延片,而不是像纯硅晶圆一样直 首页 知乎知学堂 发现 等你来答 制造而成的晶圆片,衬底可以直接进入晶圆制造环节生产半导体器件,也可以进行外延工艺加工生产外延片。为什么碳化硅要用外延,而不是直接切一片厚的晶圆? 知乎

黑碳化硅和绿碳化硅有哪些区别 知乎
2021年6月21日 1、黑碳化硅含SiC约985%,其韧性高于绿碳化硅,大多用于加工抗张强度低的材料,如玻璃、陶瓷、石材、耐火材料、铸铁和有色金属等。 2、绿碳化硅含SiC99%以上,自锐性好,大多用于加工硬质合 2020年12月30日 摘要:简述了在SiC材料半导体器件制造工艺中,对SiC材料采用干法刻蚀工艺的必要性总结了近年来SiC干法刻蚀技术的工艺发展状况 半导体器件已广泛应用于各种场合,近年来其应用领域已拓展至许多高温 碳化硅(SiC)器件制造工艺中的干法刻蚀技术材料2022年9月27日 SiC产业链包括上游的衬底和外延环节、中游的器件和模块制造环节,以及下游的应用环节。其中衬底的制造是产业链技术壁垒最高、价值量较大环节,是未来SiC大规模产业化推进的核心。1衬底 衬底价值量占比46%,为最核心的环节。由SiC粉经过长晶、加工、切割、研磨、抛光、清洗环节最终形成碳化硅产业链 SiC产业链包括上游的衬底和外延环节、中游

沟槽型SiCMOSFET工艺流程及SiC离子注入 电子工程专辑
2022年10月26日 ^1沟槽型SiC MOSFET 工艺流程 在提高 SiC 功率器件性能方面发挥重要作用的最重要步骤之一是器件制造工艺流程。SiC功率器件在用作n沟道而不是p沟道时往往表现出更好的性能;为了获得更高的性能,该器件需要在低电阻率的 p 型衬底上外延生长。2022年8月8日 上海微系统所异质集成 XOI 课题组在晶圆级的高性能 SiC 单晶薄膜的制备上开展了长期的、系统的研究: 2019 年,制备出高均匀度、4 英寸的碳化硅单晶薄膜( SiCOI )异质衬底,开发了 SiC 微纳光子结构加工工艺 【 Opt Mater 107, (2020)】上海微系统所发表关于碳化硅单晶薄膜制备技术及集成光子 2023年4月1日 平面结构的SiC MOSFET具有可靠性高,设计加工简单的优点。 安森美用在汽车主驱逆变器里的SiC MOSFET的Rsp 从代M1的42 mΩ * cm2降低到M2的26 mΩ * cm2,目前的最新的M3e常温下的Rsp性能和友商的沟槽结构的SiC MOSFET的水平一致,而高温下的Rsp则低于友商沟槽结构SiC MOSFET的Rsp,达到了行业领先的水平。碳化硅芯片的设计和制造 知乎

揭秘!第三代半导体全球晶圆代工格局 知乎
2021年6月30日 SiC/GaN代工:Fabless根据自身器件要求开发专有工艺,然后转移到代工厂生产。没有相对标准的工艺流程,考验的是Foundry的特色开发能力、技术经验及客制化服务等综合能力。另外,现阶段越来越多的SiC/GaN Foundry陆续向上延伸,涉足外延片代工。2022年3月4日 随着对性能优于硅基器件的碳化硅(SiC)功率器件的需求不断增长,SiC制造工艺的高成本和低良率是目前亟待解决的问题。已经表明,SiC 器件的性能在很大程度上受到晶体生长过程中形成的所谓致命缺陷的影响。在改进用于降低缺陷密度的生长技术的同时,能够识别和定位缺陷的生长后检测技术已 SiC中的缺陷检测技术,Nanoscale Research Letters XMOL2020年10月17日 关于磨削加工,最重要的20个重点问题答疑 1、什么是磨削加工? 试举出几种磨削加工形式。 答:磨削加工是借助磨具的切削作用,除去工件表面的多余层,使工件表面质量达到预定要求的加工方法。 常见的磨削加工形式通常有:外圆磨削、内圆磨削、 关于磨削加工,最重要的20个重点问题答疑 知乎

基于水辅助的飞秒激光碳化硅微孔加工 电子工程专辑 EE
2021年7月20日 基于水辅助的飞秒激光碳化硅微孔加工 摘 要:在 350 μm 厚的碳化硅样品上加工了直径 200 μm 的微孔,研究了基于水辅助的飞秒激光碳化硅微孔加工方法。探讨了空气中加工微孔与水辅助加工微孔的差别。水降低了加工区域的温度,大大减少了氧化反应的发生,而且加工产生的碎屑由水带走,避免了 2022年12月1日 碳化硅因其出色的物理性能,如高禁带宽度、高电导率和高热导率,有望成为未来制作半导体芯片的主要材料之一。 为了确保SiC器件的优质应用,本文将详细介绍SiC器件制造中的离子注入工艺和激活退火 一文了解碳化硅(SiC)器件制造工艺 ROHM技术社 2022年8月12日 空间反射镜中的摆镜多采用金属材料(如铝和铍及其合金材料)制成,但铝及其合金材料具有抗变形能力差的特点,而铍及其合金材料则含有剧毒,且价格较为昂贵。上世纪70年代开始,国外已经开始使用碳 新型轻质反射镜材料——碳化硅 知乎

一文看懂半导体刻蚀设备 知乎
2021年10月11日 3D NAND主要增加堆叠成熟而不是缩小线宽,刻蚀要在氧化硅和氮化硅一对的叠层结构上,加工40:1到60:1的极深孔或者极深的沟槽,因此3D NAND层数的增加将继续增加对刻蚀技术的依赖。 根据东京电 2022年6月13日 在论述这些基础理论的同时,重点总结了近年来SiC材料与器件的主要研究成果,以及今后的发展趋势。 本书可作为高等学校电子科学与技术、微电子技术等专业本科高年级学生、研究生的教学用书或辅助教材,也可作为从事SiC或其他宽禁带半导体材料与器件研究 精品书籍不容错过《碳化硅半导体材料与器件》附PDF下载 2023年4月1日 平面结构的SiC MOSFET具有可靠性高,设计加工简单的优点。 用在汽车主驱逆变器里的SiC MOSFET的Rsp 从代M1的42 mΩ * cm2降低到M2的26 mΩ * cm2,目前的最新的M3e常温下的Rsp性能和友商的沟槽结构的SiC MOSFET的水平一致,而高温下的Rsp则低于友商沟槽结构SiC MOSFET的Rsp,达到了行业领先的水平。SIC MOSFET碳化硅芯片的设计和制造 知乎

SiC沟槽刻蚀 知乎
2022年8月3日 SiC沟槽刻蚀 沟槽结构可实现功率器件的小型化和低电阻,我们提供实现沟槽结构的干法刻蚀技术。 挑战 沟槽形状的控制在高耐压应用中,为了避免电解集中,沟槽结构底部需要圆形 低刻蚀速率SiC坚硬,是化学特性稳定的SiC的同质外延是指,和SiC衬底具有相同聚合态的外延层生长。 所谓SiC外延片,是指在碳化硅衬底上生长一层更高晶格品质的单晶薄膜(外延层),在实际应用中一个个碳化硅芯片都是采用光刻、掩膜、掺杂等半导体制程工艺在这个外延层上得以实现,而碳化硅晶片本身是作为衬底实现支撑作用。【科普】SiC产业链之外延片 碳化硅产业链碳化硅产业链 2022年3月22日 微孔加工 / 电镀金刚石钻头 / 钻削加工 Abstract: Six kinds of diamond electroplated bits, whose diameters were 0280~0440 mm and the basic particle sizes of diamond were 20~30, 36~54 and 63~75 μm, were used to drill micro holes of threedimensional needlepunched feltbased C/SiC composite materials The optimum C/SiC复合材料微孔的电镀金刚石钻头钻削加工

第三代半导体材料碳化硅(SiC)研究进展 知乎
2021年6月11日 1 碳化硅的制备方法 碳化硅产业链主要包含粉体、 单晶材料、 外延材料、 芯片制备、 功率器件、 模块封装和应用等环节。 SiC 粉体:将高纯硅粉和高纯碳粉按一定配比混合, 于2,000 ℃以上的高温下反应合成碳化硅颗粒, 再经过破碎、 清洗等加工工序, 获得可以满足晶体生长要求的高纯度碳化硅 2017年8月15日 2 SiC陶瓷加工工艺研究 主要探讨磨削工艺参数与SiC陶瓷表面粗糙度的关系, 得出它们之间的影响关系,以便有效地控制磨削表面质量。 (1)刀具选择 对于数控加工中心,在加工前,初步选择两类刀具,一种是金刚石刀具,一种是立方氮化硼陶瓷刀具。 SiC陶瓷磨削加工工艺探究doc 原创力文档2022年10月3日 我们利用 7 µm 深的沟槽,并且在其侧壁上注入 p,提出了一种 1700V SiC 超结器件[1]。 ROHM 器件不是超结器件,它们的 p 型沟槽只是我们提出的那些器件的一小部分,但我们怀疑超结原理在源极沟槽 碳化硅(SiC)纵览—第 4 期:罗姆第四代 SiC

SiC基芯片背面通孔刻蚀工艺研究 知乎
2020年12月20日 SiC基芯片背面通孔刻蚀工艺研究 摘要:通过对感应耦合等离子体 (ICP)设备装片夹具进行改进,提高了背氦的导热效率,减小了下电极基底与晶圆表面之间的温度差,提高了冷却效果。 对装片夹具改进前后进行了对比实验,并分析了射频功率、ICP功率、 2021年1月31日 ①黑碳化硅含SiC约985%,其韧性高于绿碳化硅,大多用于加工抗张强度低的材料,如玻璃、陶瓷、石材、耐火材料、铸铁和有色金属等。 ②绿碳化硅含SiC99%以上,自锐性好,大多用于加工硬质合金 黑碳化硅百度百科2022年1月21日 碳化硅衬底加工难点 四、切割磨损高,由于碳化硅的硬度极大,在对其进行切割时加工难度较高且磨损多。 昂贵的时间成本和复杂的加工工艺使得碳化硅衬底的成本较高,限制了碳化硅的应用放量。 此外,晶片尺寸越大,对应晶体的生长与加工技术难度越 碳化硅晶片加工过程及难点 知乎
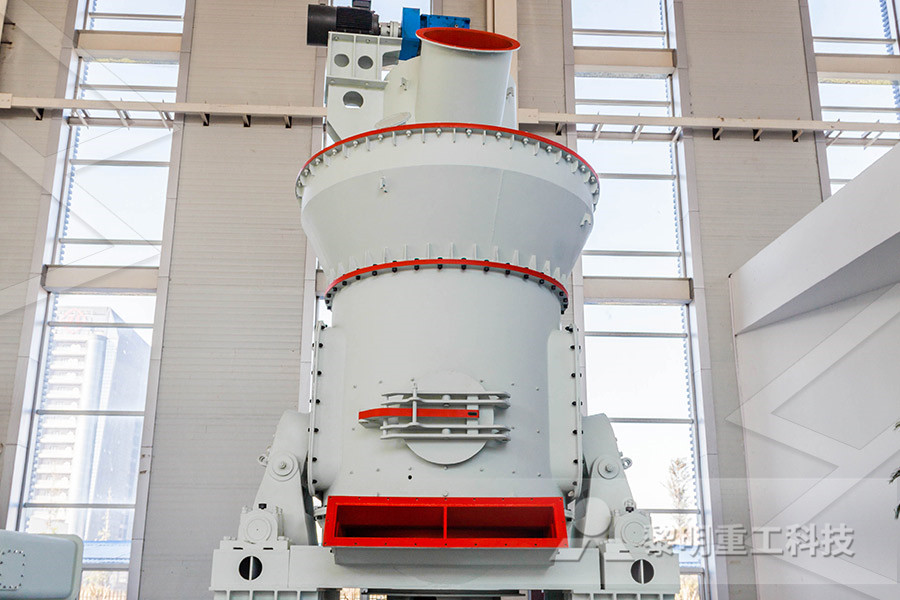
揭秘碳化硅芯片的设计和制造 知乎
2023年4月6日 以下是SiC MOSFET Rdson设计的一些关键考虑因素: 1 通道宽度和掺杂:SiC MOSFET的通道宽度和掺杂浓度会影响Rdson和电流密度。 较宽和重掺的通道可以降低Rdson并提高电流承载能力。 2 栅极氧化层厚度:栅极氧化层的厚度影响栅极电容,进而影响开关速度和Rdson 2020年1月15日 另外,SiC MOSFET能够在IGBT不能工作的高频条件下驱动,从而也可以实现被动器件的小型化。 与600V~1200V的Si MOSFET相比,SiC MOSFET的优势在于芯片面积小(可以实现小型封装),而且体二极管的恢复损耗非常小。 2 SiC Mosfet的导通电阻 SiC 的绝缘击穿场强是Si 的10倍 碳化硅(SiC)MOSFET性能的优势与技术的难点 知乎2021年5月24日 SIC外延漫谈 目前所有的碳化硅器件基本上都是在外延上实现的,外延环节是产业链的中间环节,首先,器件的设计对外延的质量性能要求高影响非常大,同时外延的质量也受到晶体和衬底加工的影响,所以SIC外延环节对产业链的整体发展起到非常关键的作用 SIC外延漫谈 知乎

碳化硅晶圆制造难在哪?做出200mm的凤毛麟角电子工程专辑
2021年8月3日 做出200mm的凤毛麟角 同时期的硅晶圆已经由200mm(8英寸)向300mm(12英寸)进发,但碳化硅晶圆的主流尺寸一直是150mm(6英寸),每片晶圆能制造的芯片数量不大,远不能满足下游需求。 真的这么难吗? 包括SiC在内的第三代半导体产业链包括包括衬底→外延→ 2022年10月28日 SiC单晶衬底加工过程包括单晶多线切割、研磨、抛光、清洗最终得到满足外延生长的衬底片。 SiC是世界上硬度排名第三的物质,不仅具有高硬度的特点,高脆性、低断裂韧性也使得其磨削加工过程中易引起材料的脆性断裂从而在材料表面留下表面破碎 碳化硅单晶衬底切、磨、抛材料整体解决方案发展加工的表面2023年4月28日 碳化硅衬底的加工主要分为以下几个工序,切割,粗磨,精磨,粗抛,精抛(CMP)。1切割 切割是将SiC晶棒沿着一定的方向切割成晶体薄片的过程。将SiC晶棒切成翘曲度小,厚度均匀的晶片,目前常规的切割方式是多线砂浆切割 2研磨详解碳化硅晶片的磨抛工艺方案 知乎